Картирование состава и толщины слоя

Металлические покрытия необходимы во многих отраслях промышленности, поскольку они обеспечивают улучшенные поверхностные свойства самых разных продуктов. Металлические покрытия могут обеспечить прочный, устойчивый к коррозии слой для защиты основного материала и помочь минимизировать износ металлических изделий. Металлические покрытия, помимо прочего, могут улучшить электропроводность, сопротивление крутящему моменту и паяемость. Контроль качества состава и толщины покрытий имеет решающее значение для обеспечения правильных свойств и долговечности покрытия.
Когда требуется строгий контроль качества металлических покрытий, лучшим общим решением является рентгенофлуоресцентный анализ (XRF). Микро-XRF-прибор Bruker M1 MISTRAL может одновременно измерять толщину покрытия и его состав. Помимо анализа покрытий, M1 MISTRAL также может измерять химический состав металлических сплавов, жидкостей для гальванических ванн, пластмасс и многих других материалов.
С помощью микро-XRF анализ слоев (толщины и состава) становится возможным с пространственным разрешением в микрометровом масштабе. Программное обеспечение M4 TORNADO и XMethod позволяет осуществлять прямую количественную оценку сопоставлений на уровне.
Поскольку рентгеновские лучи могут проходить через вещество, XRF в целом позволяет определять толщину слоя. С помощью микро-XRF анализ слоев (толщины и состава) становится возможным с пространственным разрешением в микрометровом масштабе. Послойный анализ сильно основан на количественной оценке основных атомарных параметров и может быть улучшен с помощью стандартных образцов. Таким образом, можно с высокой точностью измерить «общие» системы слоев, такие как покрытия ENEPIG, покрытия ZnNi или слои припоя, стандарты которых легко доступны, но также можно испытать новые системы слоев в среде НИОКР.

Образец, два электрода на стеклянной подложке, представляет собой испытательное устройство для фотоиндуцированного электролиза. Он состоит из биметаллического монослоя с градиентом концентрации вдоль поверхности. Стеклянная подложка покрыта магнетронным распылением двойной Cu-Al-мишени.

Вся площадь образца 5 x 5 см² была нанесена на карту с пространственным разрешением 50 мкм и временем измерения 50 мс на пиксель. Элементное распределение элементов слоя Al и Cu ясно показывает градиент концентрации.
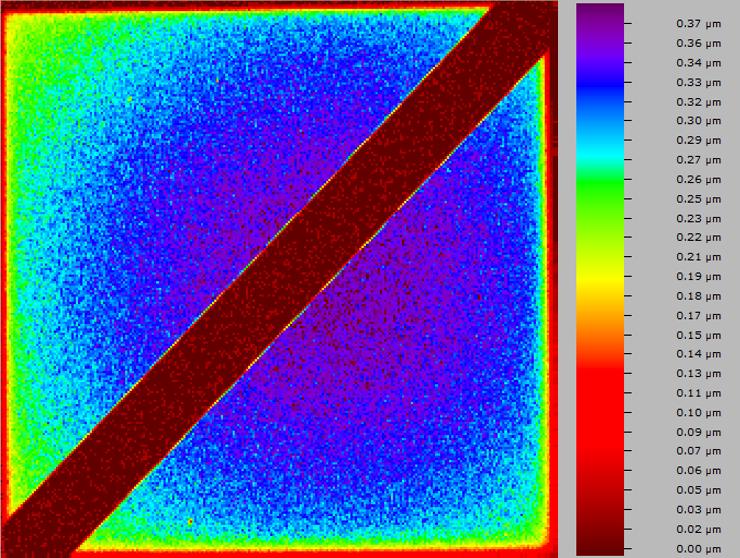
Данные карты были количественно определены для толщины Cu: Al на Si с интервалом 5x5 пикселей (что дает разрешение 250 мкм для анализа толщины слоя). Для таких новых систем образцов нет эталонных образцов. При этом количественная оценка была основана на фундаментальных параметрах, и результаты хорошо соответствовали ожиданиям производителя.


